박막공학 [6] SiO2의 성질과 용도, 결정 구조 (Intrinsic / Extrinsic)
박막공학 [5] Wafer의 제조, 단결정 성장 이론, 편석 계수 등박막공학 [4] MOSFET의 구성과 작동 원리, 주요 term박막공학 [3] Defect/ 불순물/ 고용 포화도(Solid Solubility)박막공학 [2] 반도체의 Band 구조와 Mo
mayunchem.tistory.com
1. Si의 Oxidation 의 두 가지 방법
Si은 크게 두 가지 방법으로 Oxidation을 한다. Dry/ Wet Oxidation 방법이 그 두 가지 이다.
1-1. Wet Oxidation (습식 산화)
Si (solid) + 2H₂O (gas) → SiO₂ (solid) + 2H₂ (gas)
위의 화학식과 같은 반응을 하여 만드는 산화를 하는 방법으로, 수증기를 이용하여 산화막을 형성한다.
반응 속도가 빠르며, 두꺼운 산화막 형성에 유리하지만, 막질이 나쁘다는 단점 역시 존재한다.
1-2. Dry Oxidation (건식 산화)
Si (solid) + O₂ (gas) → SiO₂ (solid)
순수 산소 가스만을 사용하는 반응으로, 반응 속도는 습식 산화에 비해 비교적 느리지만 얇고 균일한 산화막 형성에 유리하며, Gate Oxide에 사용하며 할로젠 가스(HCl)을 첨가하여 SiO2 내의 mobile ion을 고착화하고 계면특성을 향상 시키기도 한다.
소자가 점차 미세화되가면서 Gate oxide의 두께가 얇아지는 추세이기 때문에, Wet oxidation보다 Dry Oxidation 방식을 더 선호하는 경향이 있다.
2. Oxidation 장비
아래 장비 사진은 수평형 열산화 장비로, Wet/Dry Oxidation을 둘 다 수행할 수 있다.

실리콘 웨이퍼들이 수평으로 삽입된 Quartz boat에 수직으로 세워져 있고, 퍼니스는 가열로에 둘러싸여 고온을 유지한다. 가스 장비를 보면 HCl, N2, H2, O2 등이 있는 것을 확인 할 수 있는데, 여기서 H2와 O2를 함께 공급하면 증기를 형성 할 수 있어 습식 산화도 가능하다.
HCl은 실리콘 웨이퍼 표면에 존재하는 금속 불순물을 휘발성 염화물의 형태로 바꿔 제거한 후 배기 라인을 통해 외부로 배출되게 한다. 이를 통해 고품질 Gate Oxide를 형성 할 수 있다.
N2는 산화 공정 전후 반응을 하지 않고, 잔여 가스를 밀어내는 역할을 하며 온도 안정화 및 웨이퍼를 보호한다.
2-1. 수평형 퍼니스와 수직형 퍼니스의 비교
공정에서 사용되는 Furnace도 크게 2가지 종류로 나뉘는데, 수직형과 수평형이 존재한다.

수평형 퍼니스의 경우, 쿼츠 튜브를 수평 방향으로 배치하고 웨이퍼를 보트에 담아 가로 방향으로 삽입한다. 히터는 수평 방향으로 외부에 설치되어있고, 가스의 방향도 수평방향으로 흐른다. Center Zone은 Flat Zone 반응의 핵심 영역으로 온도를 유지하는 중심부에 웨이퍼를 배치한다.
구조가 간단하고 유지보수가 쉬우며, 장비가 상대적으로 저렴하지만, 가스의 흐름과 온도의 분포가 수평방향으로 비대칭적일 수 있으며, 웨이퍼 간의 균일성이 떨어질 수 있으며, particle에 의한 오염 위험이 있다.
수직형 퍼니스의 경우, 챔버를 수직으로 세우고 웨이퍼 보트가 아래에서 위로 들어가는 수조이며, 히터는 수직 챔버의 외벽에 고르게 배치되어있어 웨이퍼간 온도나 가스 흐름의 균일성이 더 뛰어나다. 산화막의 두께나 도핑의 분포 등 공정 균일성이 매우 우수하며, 오염의 위험이 적다.
다만, 장비 구조가 복잡하며 설치나 유지 비용이 높다는 단점이 존재한다.
3. Si Oxidation에 영향을 주는 Factor
3-1. Micro - Loading Effect

Micro - Loading Effect란 공정 조건이 동일한 상황에서 패턴 밀도나 패턴 형상에 따라 식각 속도가 달라지는 현상을 의미한다. 즉, 좁은 영역이나 고밀도 패턴에서 식각 속도가 느려지는 것을 의미한다.
3-2. Heavy Doping Effect

Heavy Doping Effect이란, 도핑 농도가 매우 높을 때 단순한 캐리어의 증가를 넘어 물성 자체가 변하는 것을 의미한다. P의 농도가 증가하면 산화 속도가 증가하여, 더 많은 vacancy를 형성해 산화막이 중앙에서 더 많이 자라는 것이 그 예이다. 뒤에서 후술할 외인성 확산과도 관련이 있다.
3-3. Orientation Effect

쉽게 말하자면, 산화 속도가 원자 충진율 정도에 따라 다른 것이다.
사진 속 그림에서 볼 수 있듯이 원자 충진율이 더 높은 (111)에서의 확산 정도가 가장 빠르고, (100)에서 가장 느린것을 확인 할 수 있다. 실제 Si 공정 시에는 확산 속도가 가장 빠른 (111)이 아닌 공정 control이 비교적 쉬운 (100)에서 공정을 진행한다.
3-4. Chloride Gas 첨가
할로젠 원소(HCl, Cl2) 등을 첨가 시 불순물을 제거해, Oxide의 성장 속도가 증가하는 것이다. 산화막에서 불순물을 제거하기 때문에, 품질이 개선되고 소자의 특성이 좋아진다.

Na+나 K+와 같은 알칼리 금속 양이온은 SiO2 내에서 이동이 가능하기 때문에 전기적으로 매우 불안정성을 가지는데, 금속 이온과 할로젠 원소가 반응하여 MCl 형태로 만들어 제거한다. 또한, HCl을 조금만 첨가해도 Etch Rate가 증가한다.

위 그래프는 산화막 성장의 계면 지배 반응 단계를 나타내며, 온도 상승과 HCl 농도의 증가에 따라 B 값도 증가하는 것을 보이는데, 계면에서 Si 반응이 촉진되는 것을 보인다. 또한, HCl 농도가 낮을 때는 빠르게 증가하다가 2~4% 수준에서 포화되는 것도 확인 할 수 있다.
4. Si Thermal Oxidation 공정 중 Re-Distribution
SiO2를 열 산화를 통해 형성할 때, Dopant는 고정되어있지 않고 산화막과 기판사이의 경계를 기준으로 이동하는데, 이때 도펀트의 확산 계수나 산화막 내 용해도, 인터페이스에서 분배계수 등에 따라 재분포 현상이 달라진다.
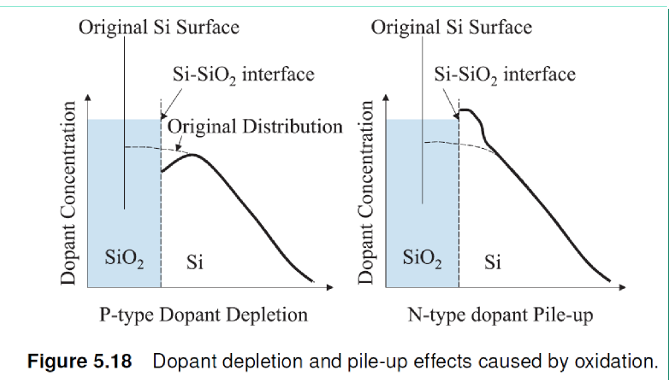
P형 도펀트는 Oxidation 중에 SiO2에 잘 들어가지 못하는데(용해도가 낮음) interface를 기준으로 Si 쪽에서 밀려나며 농도가 중러들기 때문에 Si 영역 내에서 Dopant 농도가 감소한다.
반대로, N형 도펀트는 산화막 경계에 머무르나 잘 확산되지 않는다. 따라서, 산화막 내에 들어가기 보다는 인터페이스에 집적되며, 농도가 상승된다.
'학교 수업 > 박막공학' 카테고리의 다른 글
| 박막공학 [9] Dopant 이온 주입 방식/ Activation Annealing과 장비 (0) | 2025.04.24 |
|---|---|
| 박막공학 [8] Si/ SiO2의 계면 결함과 비파괴 측정 방식 (4) | 2025.04.24 |
| 박막공학 [6] SiO2의 성질과 용도, 결정 구조 (Intrinsic / Extrinsic) (0) | 2025.03.30 |
| 박막공학 [5] Wafer의 제조, 단결정 성장 이론, 편석 계수 등 (0) | 2025.03.29 |
| 박막공학 [4] MOSFET의 구성과 작동 원리, 주요 term (0) | 2025.03.29 |