박막공학 [13] Ion Implantation(이온주입) (2)
박막공학 [12] Ion Implantation(이온주입) (1)박막공학 [11] 외인성 확산과 측면 확산박막공학 [10] 확산 공정(Diffusion)의 두 가지 단계/ Diffusion 반응식과 공정 장비우리가 지난 시간에 Dopant의 주입 방식
mayunchem.tistory.com
1. Gaussian Profile
이온을 반도체에 주입하면 각 이온은 기판 내 특정 깊이까지 도달한 후 멈추는데, 이때 분포는 가우시안 분포 Gaussian Profile를 가진다.



1-1. 이온 주입된 dopant의 깊이 분포 (Rp vs. △Rp)
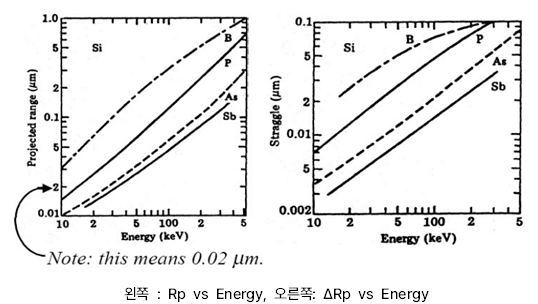
왼쪽 그래프의 경우, 이온 에너지가 높을 수록 깊이(Rp)의 증가하고, 질량이 가벼울 수록 더 멀리 도달하는 것을 알 수 있다.
(B > P > As > Sb)
오른쪽 그래프의 경우, 에너지가 클수록 분포폭(ΔRp)이 증가하고, 이온이 클수록 좁은 분포를 가진다.
1-2. Dose vs. Peak Concentration(Cp)

위의 적분 식을 통해 같은 Qdose라도 ΔRp가 작을수록 Cp(최대 도펀트 농도)가 커진다는 것을 알 수 있다.
1-3. Junction Depth의 정의
Junction Depth
:도펀트의 농도 C(x)가 기판 고유 농도와 같아지는 깊이

1-4. Chaneling 현상
가우시안 profile은 좌우대칭이고 Rp와 △Rp로 정의되지만, 실제는 기판 상호작용, Channeling 현상 등으로 tail이 생긴다.
Channeling
: 결정성 Si 내애서 이온이 결정 구조의 빈틈(Channel)을 따라 충돌없이 깊이 침투하는 현상
대부분의 이온은 Lattice Atom들과 충돌하며 감속하여 Rp에서 멈추지만, <100> <111> <110> 방향의 채널구조를 따라가면 충돌없이 침투 할 수 있다.

이러한, Channeling 현상으로 인해 Gaussian Profile 끝에 농도 tail이 생긴다. 이러한 Tail로 인해 Junction Depth의 예측이 어려워지고, Shallow Junction 구현이 어려워지는 문제가 생긴다.

그렇다면, Channeling 현상을 최소화할 수는 없을까?
1-4-1. Channeling의 최소화
Channeling 현상을 최소화할 수 있는 방법은 크게 2가지가 있다.
첫번째는, Wafer를 <100>에서 7.4도 tilt 하여 이온주입하여 직접적 이온 진입을 막는 방법이다. 결정 방향에 대해 tilt angle의 변화에 따라 농도 tail이 줄어드는 모습이다.
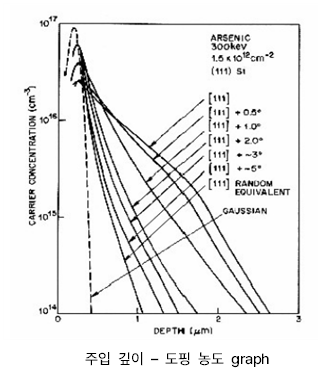
두번째는, Ge Pre-amorphization Implantation 공정으로, Source/ Drain 도핑 전에 Ge이온을 먼저 저에너지로 Si 기판 주입하여, 표면을 비정질(Amorphous) 상태로 변환시키는 방법이다.
'학교 수업 > 박막공학' 카테고리의 다른 글
| 박막공학 [16] Deposition (증착) (1) (5) | 2025.07.30 |
|---|---|
| 박막공학 [15] Ion Implantation (이온주입) (4) (0) | 2025.07.30 |
| 박막공학 [13] Ion Implantation(이온주입) (2) (4) | 2025.07.30 |
| 박막공학 [12] Ion Implantation(이온주입) (1) (4) | 2025.07.30 |
| 박막공학 [11] 외인성 확산과 측면 확산 (0) | 2025.04.24 |