박막공학 [11] 외인성 확산과 측면 확산
박막공학 [10] 확산 공정(Diffusion)의 두 가지 단계/ Diffusion 반응식과 공정 장비우리가 지난 시간에 Dopant의 주입 방식 중 하나가 Diffusion 방식이었고, 다른 하나는 Ion Implantation 방식이었다. 오늘은
mayunchem.tistory.com
1. Ion Implantation vs. Diffusion
이온주입에 대해 알기 위해서는 가장 먼저 이전 시간에 배웠던 확산 Diffusion 공정과의 비교가 필요하다.

이온 주입 공정은 고속으로 가속된 도펀트 이온이 저온에서 수직으로 기판에 향하며 이루어 지며, 그림 속 Mask는 도핑이 필요하지 않은 영역을 막기 위해 사용되는 차폐층으로, SiO2나 Photoresist가 주로 사용된다. 타원형의 영역은 도펀트 이온이 집중적으로 들어간 영역으로, 이온들이 충돌 및 감속되며 분포를 이룬다.

2. Ion Implantation과 Doping Concentration
이온 주입을 통해 도핑 농도 분포 그래프를 얻을 수 있다.

이때, 구간에 따라 도핑 농도가 변화가 있는 것을 확인할 수 있는데, 이는 Ion Implantation의 doping Mechanism과 관련이 있다.

그렇다면, 왜 좌우 대칭이 아닌 한쪽으로 치우친 형태가 될까?
첫번째로, 전자적 에너지 손실 (Electronic stopping), 핵적 에너지 손실 (Nuclear stopping)이 그 이유이고, 두번째로는 Channeling효과가 그 이유이다. 이는 뒤에서 차차 다루어 보겠다.
2-1. Ion Implantaion에서 Doping 분포 제어의 기본 개념과 주요 변수, 마스크
이온 주입 공정에서 Setting Parameter는 크게 3 가지가 있다.
① Dopant 종류, ② 가속 전압(에너지), ③ Φ( Dose )
여기서, Φ( Dose )는 concentration과는 다른 개념으로 이 두가지를 구분할 수 있어야 한다.

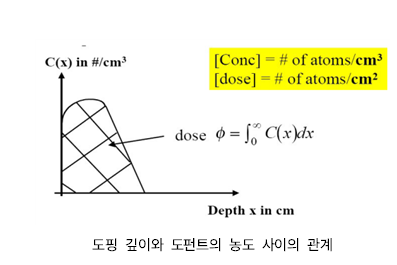
Q dose에 대해 조금 더 자세히 알아보자.

Q_dose는 전류 × 시간 꼴이므로 Current ∝ 1/ Time (시간과 전류가 반비례) 관계를 가진다.
즉, High Current = 짧은 시간 = Throughput(공정 처리량) ↑이다.
Source/ Drain는 Qdose가 높지만 ultra-shallow junction이 필요
→ 높은 전류로 빠르게 많은 이온을, 낮은 전압으로 얕게 주입
= High Current Implanter
2-2. Ion Implantation의 주요 변수
Ion Implantation의 주요 변수 (이온 주입 깊이, 분포 Concentration, Mask) 를 말하자면 다음과 같다.
1) 이온 주입 깊이 (Junction Depth)와 분포 모양은 이온 에너지에 의해 결정된다.
고에너지 이온은 더 깊은 곳까지 침투가 가능하다
→ 주입 깊이가 증가
→ 이온 진입 경로가 증가하여 그래프가 오른쪽으로 이동하고 분포 폭이 증가
2) 분포의 높이(Concentration)은 Qdose에 의해 결정된다.
∴ 그래프에서 가로 방향인 x축의 분포는 에너지로 제어, 세로 방향인 y축의 분포는 이온 Dose에 의해 결정된다.
3) 이온 주입 마스크
| Thick Mask | 이온을 완전 차단하여 도핑 차폐 가우시안 프로파일이 표면에 존재 X |
| Thin Mask | 이온을 일부 통과, 깊이 얕고 농도 낮은 도핑 가우시안 프로파일이 표면에 존재 |
ex. Photoresist, SiO2, Si3N4..

3. Ion Implanter
Ion Implanter의 구조와 각각의 역할을 살펴보자.

1) Ion Source (이온 소스)
- 도펀트 기체 ex. AsH3, AsH2, AsH+, As+ 등을 사용
- 이온화 시켜 원하는 이온 (As+)을 사용
Q. 왜 As+을 사용할까?
A. H가 격자 내에 들어가면 interstitial로 들어가기 때문에 수소 기체가 발생하여 기포가 발생한다 (불량률이 높아진다)
2) Magnetic Mass Seperation (질량 분석기)
: As+ 만 선택하고, H+나 AsH+ 등을 제거하는 장치
- 질량 – 전하비를 이용한 자기장 분리 방식를 이용한다. 이때 휘는 반경은 전하량/질량에 비례한다.

3) Accelerator Column (가속기)
- 선택한 이온에 고전압을 걸어 가속 ( 주입 깊이를 결정 )
4) Ion Beam
가속된 이온이 수직방향으로 웨이퍼를 향해 주입
5) Wafer Holder
웨이퍼가 회전과 이동을 하며 빔을 고르게 노출
→ 균일한 C(x) profile을 가짐

3-1. Faraday Cup


'학교 수업 > 박막공학' 카테고리의 다른 글
| 박막공학 [14] Ion Implantation (이온주입) (3) Gaussian Profile과 Channeling (2) | 2025.07.30 |
|---|---|
| 박막공학 [13] Ion Implantation(이온주입) (2) (4) | 2025.07.30 |
| 박막공학 [11] 외인성 확산과 측면 확산 (0) | 2025.04.24 |
| 박막공학 [10] 확산 공정(Diffusion)의 두 가지 단계/ Diffusion 반응식과 공정 장비 (0) | 2025.04.24 |
| 박막공학 [9] Dopant 이온 주입 방식/ Activation Annealing과 장비 (0) | 2025.04.24 |