박막공학 [12] Ion Implantation(이온주입) (1)
박막공학 [11] 외인성 확산과 측면 확산박막공학 [10] 확산 공정(Diffusion)의 두 가지 단계/ Diffusion 반응식과 공정 장비우리가 지난 시간에 Dopant의 주입 방식 중 하나가 Diffusion 방식이었고, 다른 하
mayunchem.tistory.com
1. Ion Implantation의 Energy 손실 Mechanism
이온의 ‘질량’과 ‘에너지’에 따라 에너지 손실 메커니즘이 달라진다.

이온이 실리콘 내부로 주입될 때 에너지를 잃으면서 감속되는 과정에서 두 가지의 주요 매커니즘이 작동한다.
1) Sn(E); Nuclear Stopping Power
이온과 기판 원자핵의 충돌로 인한 에너지 손실 (결정 손상 유발)
이 매커니즘은 무거운 원소일 때 우세하고, As+가 대표적이다.
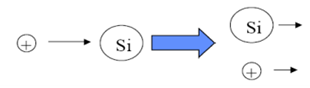
2) Se(E); Electronic Stopping Power
: 이온과 기판 전자 사이의 상호작용으로, 전자 들뜸이나 열이 발생한다.
가벼운 원소일 때 우세하고, H+나 B+가 대표적이다.

위의 메커니즘을 ion의 무게에 따라 다시 분류해보자.
1-1. Ion의 무게에 따른 Stooping의 분류

1-2. 에너지에 따른 Stopping 비율의 변화

위 그래프를 통해서, 저 에너지에서는 Nuclear Stopping이 지배적이고, 고 에너지에서는 Electronic Stopping이 점점 증가하여 지배적이다.
1-3. 깊이에 따른 손상 분포
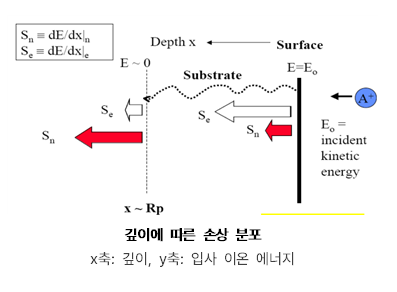
초기에는 Se(E)가 Sn(E)가 우세하기 때문에 전기적 들뜸이 주도적이고, 열이 생성된다. 그러나, 말기에는 에너지가 낮아져 Sn(E)가 우세하므로 격자 손상이 집중적이다.
즉, kinetic E를 많이 잃으면 Sn(E)가 우세하다.
따라서, 표면 근처에서는 손상 정도가 작고(Elctronic Stopping), 깊은 지점에서는 손상 정도가 크다(Nuclear Stopping). 참고로 모든 dopant는 Electronic과 Nuclear Stopping E가 동시에 발생한다.
2. Dopant Activation Annealing
고 에너지로 이온 도펀트를 주입하면, Si 격자에서 defect가 발생하고 dopant의 격자 구조가 깨지게 된다. 이를 복구하고, dopant를 활성화하기 위해서 고온 열처리가 필요하다.
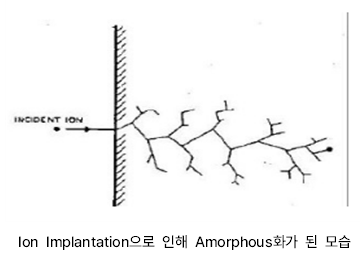
하지만 이러한 annealing으로 인해 dopant가 확산되어 junction Depth가 증가할 수 있다.

2-1. EOR ( End of Range )
주입 깊이의 끝 부분에 해당하는 최대 손상 영역
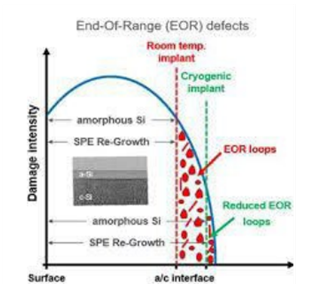
따라서 적절한 Annealing 방식인 RTA(Rapaid Thermal Annealing)을 이용하여 이를 복구하고자 한다.
2-2. Implantation Damage의 회복 조건
Q dose와 Temp 사이의 관계를 알아야 annealing 조건을 알 수 있다.
- Dose가 낮을수록, 결정화시 필요한 온도의 증가
- Dose가 높을수록, 비정질화가 잘되어 결정 시작 온도가 낮아짐

따라서, 온도에 따라 비정질화 임계 dose가 다르고 무거운 이온일수록 적은 양(dose)로도 비정질화가 가능하다. (∵ Nuclear Stopping이 크기 때문)
'학교 수업 > 박막공학' 카테고리의 다른 글
| 박막공학 [15] Ion Implantation (이온주입) (4) (0) | 2025.07.30 |
|---|---|
| 박막공학 [14] Ion Implantation (이온주입) (3) Gaussian Profile과 Channeling (2) | 2025.07.30 |
| 박막공학 [12] Ion Implantation(이온주입) (1) (4) | 2025.07.30 |
| 박막공학 [11] 외인성 확산과 측면 확산 (0) | 2025.04.24 |
| 박막공학 [10] 확산 공정(Diffusion)의 두 가지 단계/ Diffusion 반응식과 공정 장비 (0) | 2025.04.24 |